アプリケーション
半導体 & ナノテクノロジー
- Application note
- No. SEN001-IFCF-20230315-001-JP
周波数領域サーモリフレクタンス法を用いたアモルファス Ge1-xSnx 薄膜の熱伝導率の測定
- キーワード
- 半導体
- ナノテクノロジー
- 周波数領域サーモリフレクタンス法
- InFocus BB-FDTR
Sn 組成の異なるアモルファス Ge1-xSnx 薄膜の熱伝導率を周波数領域サーモリフレクタンス法(FDTR)を用いて測定しました。その結果、アモルファス Ge1-xSnx 薄膜の熱伝導率は Sn組成が 6 %から 13 %へ増加するにつれて 0.50 W/mK から 0.44 W/mK に減少し、最小熱伝導率モデルで計算されるアモルファス限界値とよく合致する傾向を示すことが分かりました。
公開日:2023年3月24日
PDFをダウンロードするイントロダクション
半導体デバイスの性能と信頼性を向上させるためには、構成材料の熱輸送特性を深く理解し、デバイスの熱設計を最適化することが重要です。とくに近年では、半導体材料の薄型化や微細化が進んでいるため、薄膜やナノスケールの材料の熱物性を正確に測定するための信頼性の高い手法が求められています。
レーザーフラッシュ法は、バルク材料の熱拡散率を測定するために広く使用されている手法です。レーザーフラッシュ法では、試料表面をパルスレーザーで加熱し、裏面の温度上昇の時間特性から試料の熱拡散率を求めます。しかし測定対象が薄膜の場合、温度応答が速くなり過ぎるため検出が難しくなります。一方、光ポンプ・プローブ法である周波数領域サーモリフレクタンス(FDTR)法は、温度応答であるサーモリフレクタンス信号の位相遅れを解析することで、厚さ数 10 nmから数 µmの薄膜のさまざまな熱物性値を測定することができます。
このアプリケーションノートでは、サイエンスエッジ社製のサーモリフレクタンス顕微鏡 InFocus FDTR を使用して、Sn 組成の異なるアモルファス Ge1-xSnx 薄膜の熱伝導率を測定しました。
試料準備
シリコン基板(抵抗率:1~ 20 Ωcm、厚さ:404 µm)上にSn 組成の異なる a-Ge1-xSnx 薄膜4種を RF スパッタにて作成しました。いずれの試料も、その表面にトランスデューサーとして 62 nm 厚のAuを成膜し、Auと薄膜の間には密着性を高めるために 5 nm 厚のCr層を挟んでいます。4種のa-Ge1-xSnx 薄膜のSn組成と厚さを表1に示します。
表1. a-Ge1-xSnx 薄膜試料4種のSn組成と膜厚一覧。シリコン基板の厚さは 404 µmです。
1
2
熱伝導率の測定
薄膜の熱伝導率は、サイエンスエッジ社製のサーモリフレクタンス顕微鏡InFocusFDTRを用いて測定しました。強度変調させた波長 488 nm のポンプレーザーで試料表面を周期加熱し、サーモリフレクタンス信号の強度変化によって表面温度をモニターするために波長 532 nm のプローブレーザーを同軸で照射しました。ポンプレーザーの変調周波数を 200 kHz から 10 MHz まで変化させながら、入射熱流束に対するサーモリフレクタンス信号の位相応答をロックインアンプで記録しました。200 kHz から 10 MHz までの位相応答をプロットするのにかかった測定時間は4分で、再現性を確認するために各試料3回の測定を行いました。
薄膜の熱伝導率は、3回の測定の平均の位相遅れと、薄膜の熱伝導率をパラメーターとして熱輸送モデルを用いて計算した位相遅れを比較することによって求めました。多層モデルの概略図とフィッティングに用いた物性値をそれぞれ図1および表2に示します。なお、薄膜の体積熱容量は、GeとSnの文献値(1644.8 kJ/m3K、1671.7 kJ/m3K)とその組成比から算出しました。
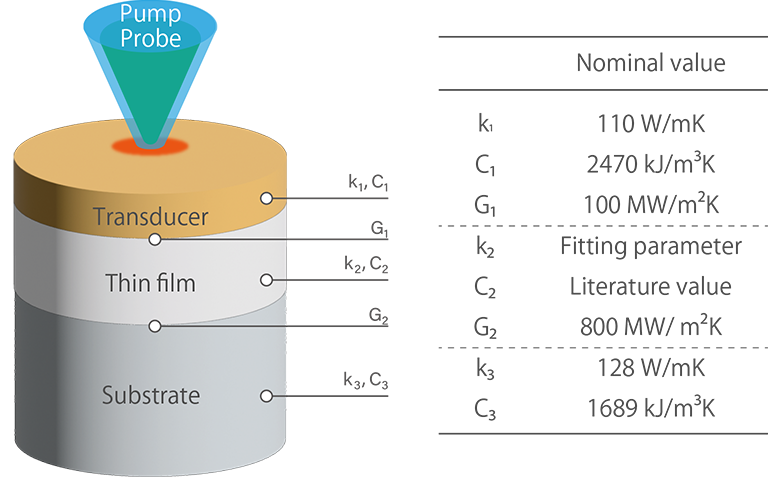
図1. 多層膜モデルの概略図。各層の熱伝導率k、体積熱容量C、膜厚のほか、界面熱コンダクタンスGがフィッティング解析に使われます。表2. フィッティング解析に用いた物性値の一覧。C2には、GeとSnの文献値の組成比から算出した値を使いました。
2
3
測定結果
図2に示すように、4種のa-Ge1-xSnx薄膜の位相プロットは、再現性良く明確な違いを示しました。図3(a)は、a-Ge薄膜の平均位相プロット(丸印)と、a-Ge薄膜の熱伝導率を 0.55 W/mK として得られたベストフィット曲線(実線)です。この測定値は、最小熱伝導率モデルによる予測値(0.62 W/mK)*1や、Cahillらによる測定値(0.51 W/mK)*2、Alvarez-Quintanaらによる測定値(0.64 W/mK)*3と近い数値です。また図3(b)には、熱伝導率を±10%(0.50~0.61 W/mK)、±20%(0.44~0.66 W/mK)変化させて得られたシミュレーション曲線と、a-Ge薄膜の3回の測定データを示しています。測定値のばらつきは±10%の範囲に比べ小さく、不確かさは±5%程度であることが分かります。
表3に残りの試料の熱伝導率の結果をまとめます。Sn組成の増加とともに熱伝導率が 0.50 W/mK から 0.44 W/mK に低下することが分かりました。この結果は最小熱伝導率モデル*4で計算されるアモルファス限界値と合致することが分かりました。
図2.a-Ge1-xSnx薄膜4種をInFocusFDTRで測定して得られた位相(縦軸)と変調周波数(横軸)のプロット。再現性を確認するために各試料の測定を3回い、その結果を色違いの円で図示しました。
図3 (a).3つのa-Geデータの位相データの平均値(丸印)とベストフィット曲線(実線)を、熱伝導率(k)を±20%変化させて得られた解(点線)と共に示した図。(b).a-Ge薄膜を3回測定した位相データ(円)のばらつきと、kを±10%、±20%変化させて得た解(点線)の比較。
表3 .a-Ge1-xSnx薄膜4種の熱伝導率の測定結果のまとめ。
結論
サイエンスエッジ社製のサーモリフレクタンス顕微鏡InFocusFDTRを用いて、Sn組成の異なるアモルファスGe1-xSnx薄膜の熱伝導率を測定することができました。この研究により、周波数領域サーモリフレクタンス(FDTR)法は、厚さ100 nm程度の薄膜材料の熱伝導率を正確に測定できる信頼性の高い手法であることが分かりました。サイエンスエッジ社製のサーモリフレクタンス顕微鏡InFocusFDTRは、薄型化や微細化が進む半導体デバイスの熱設計を最適化するための強力な熱物性計測ツールとなります。
謝辞
サンプルを提供してくださり、測定および本アプリケーションノートの原稿について有益なコメントをいただいた名古屋大学の黒澤先生、大岩様に深く感謝いたします。
参考文献
*1: Cahill et al., Phys. Rev. B 46, 6131 (1992).
*2: Cahill et al., Phys. Rev. B 37, 8773 (1988).
*3: Alvarez-Quintana et al., J. Appl. Phys 104(7) 074903 (2008).
*4: Khatami et al., Appl. Phys. Rev. 6, 014015 (2016).